三星电子与Amkor技术合作开发领先的H-Cube™解决方案狗万注册地址
在半导体领域处于世界领先地位的三星电子10日表示,开发出了适用于高性能半导体、人工智能(AI)、狗万滚球官网数据中心、网络等需要高性能和大面积封装技术的半导体的2.5D封装解决方案“Hybrid-Substrate Cube (H-Cube)”。
三星电子铸造市场战略组长兼首席副总经理姜文洙(音)表示:“与三星电机(SEMCO)和Amkor技术公司共同开发的H-Cube解决方案适用于需要集成大量硅模具的高性能半导体。”狗万注册地址狗万滚球官网“通过扩大和丰富铸造生态系统,我们将提供各种一揽子解决方案,以在客户面临的挑战中找到突破口。”
Amkor技术全球研发中心高级副总裁JinYoung Kim表示:“在系统集成需求日益增加、基板供应受到限制的今天,三星铸造和Amkor技术成功合作开发了H-Cube,克服了这些挑战。”狗万注册地址“这一进展降低了进入高性能计算/人工智能市场的门槛,证明了代工和外包半导体组装和测试(OSAT)公司之间的成功合作和伙伴关系。”狗万滚球官网
H-Cube结构和功能
2.5D封装使逻辑芯片或高带宽存储器(HBM)能够以小尺寸放置在硅插补层上。三星的H-Cube技术采用了一种混合基板,结合了一个可以进行精细凹凸连接的细间距基板,以及一个高密度互连(HDI)基板,以实现大尺寸到2.5D封装。
随着高性能计算(HPC)、人工智能(AI)和网络应用市场需求的增加,大面积封装变得越来越重要,因为在一个封装中安装的芯片数量和尺寸增加,或者需要高带宽通信。对于包括插片在内的硅模具的连接和连接,细间距衬底是必不可少的,但随着尺寸的增加,价格大幅上涨。
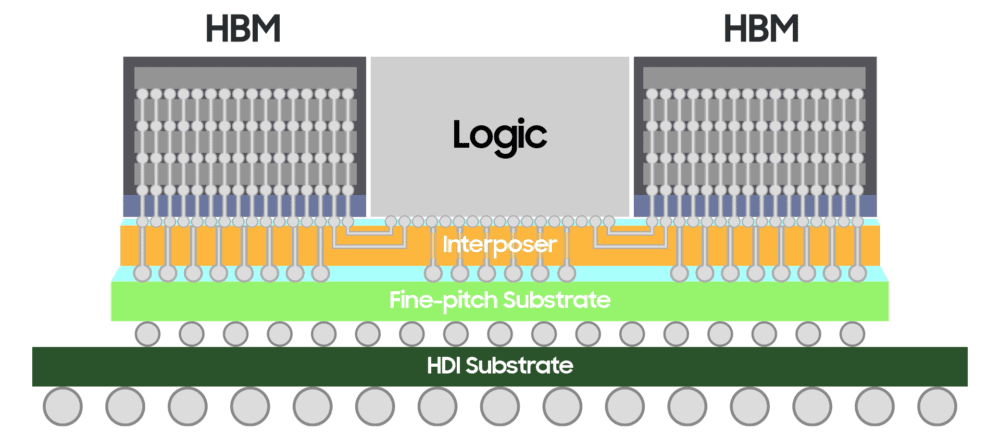
H-Cube™封装结构概念
当集成六个或更多的HBMs时,制造大面积衬底的难度迅速增加,导致效率降低。三星电子利用在高端细间距衬底上叠加大面积容易实现的HDI衬底的“混合衬底结构”解决了这一问题。
通过减少电连接芯片和基板的焊球的间距,与传统的球距相比,通过35%,可以最小化细间距基板的尺寸,同时在细微下添加HDI衬底(模块PCB)俯仰基板以与系统板固定连接。
此外,为了提高H-Cube解决方案的可靠性,三星电子还采用了自主研发的信号/功率完整性分析技术。该技术可以在叠加多个逻辑芯片和hbm时,最大限度地减少信号损耗和失真,同时稳定地供电。



