半导体ストーリー:パッケージの基本,下册

(前号から続く)リードフレームと异なり,PCB基板の重要なメリットは,ボールグリッドアレイ(BGA)パッケージの底部全体にI / Oピンを配置できる点です。全领域が接続に使用可能なので,BGAのボールピッチ(ボール间の距离)が小さくなればなるほど设置できるI / O数が増えます。
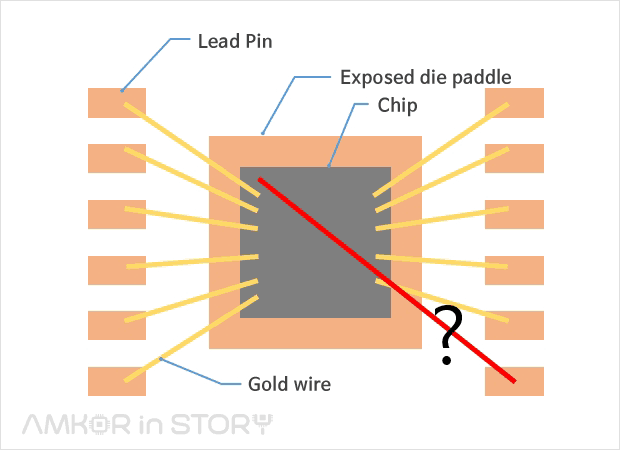
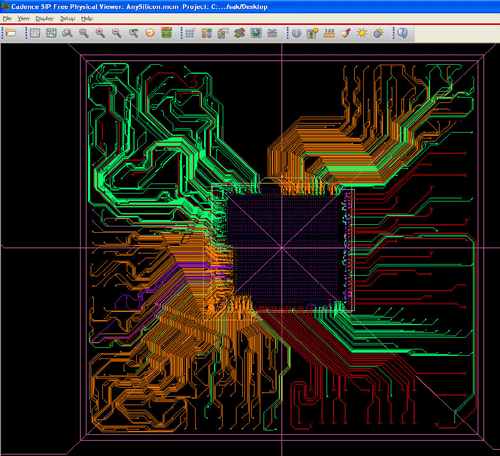
と言っても,いつもPCBを使うというわけには行きません。何故なら,PCBは当然のごとくリードフレームより高価だからです。配线层は,2层,4层と限界なく増大する可能性がありますが,それに従って制造するのは困难になります。比喩的に表现すれば,自宅から道を挟んだ店に行ってスナックとドリンクを买いたいだけなのに,结婚式に行くようなドレスアップはしないでしょう。反対の状况であっても同じです。基板の性质に応じて,ある特性は良好なものでも别の特性はそうではないという可能性もあります。そのため,制品に必要とされるパフォーマンスや価格によって何を选ぶのかが変わります。
パッケージの性能评価と设计
评価は基板设计の前段阶か同时进行で行われ,パッケージがお客様の要求に合致するかどうか确认します。その一つが热特性评価です。前回の执笔者が热性能およびその评価を取り上げましたが,私たちは制品が実际の机器に実装された际に要求の热性能を示すことができるように评価する必要があります。基准に満たない场合は,违う材料,违うサイズ,厚みを使用して再度评価します。それでもうまく行かなければ,その构造自体を変更する必要があるか,またはお客様に要件を引き下げるように提言することになります。
二つ目は电気特性です。最も一般的な评価の一つはインピーダンス特性です。パッケージが作动している时,不要な抵抗が生じ,信号の损失が起きてしまうことがあります。この评価は,インピーダンス特性を调整し损失を最小限にするために制品に适する设计値を决定するのに役立ちます。
三つ目は変形と损伤予测评価です。制品を制造または実装している间,パッケージの変形が重大な悬念材料となります。温度変化は热膨张をもたらします。热変形は异なる材料を使用したパッケージでは避けることが出来ません。それが変形だけで済めばよいですが,内部での破损や切断を引き起こす场合は大きな问题となります。しかしそれはシステムを使用して予测できます。パッケージの変形は违う材料を使用するか,构造を変更することによって许容范囲内に制限することもできます。
私が最初にこの仕事を始めたとき,先辈が,昔はコンピュータCADの代わりに定规を使って制図版に线を引いて図面を作っていたと言っていました。それはずっと昔のエピソードです。今日では技术が进歩しました。そして私たちは设计段阶で过去には悬念事项とはならなかった多くの変数について悩んでいます。もちろん今の私には说明できない设计条件もたくさんあります。システマティックな设计段阶および多くの経験豊かなエンジニアからの情报提供を通して设计は完了します。一つの制品の设计が终わり,それが実际に问题なく量产されたと闻けば,他の谁も気づかなかったとしても,私はそれを夸らしく思います。
さて,今私は次回どの话题をお届けしようかと悩んでいます。皆さんが知りたい话题があれば,返信に书いていただきたいと思います。ぜひ検讨させていただきます。では,また次号で会いましょう。
写Gyuik郑某
大志を持って安靠に入社してすでに10年になります。10年は地球を変えるのに十分な时间だとも言われますが,私はすべての仕事に対して新人のように新鲜な兴味や关心を持ち,仕事を楽しみ続けることを望んでいます。



