독자적을위한패키징솔루션
这微LeadFrame®(MLF®/QFN)包装技术是当今增长最快的IC包装解决方案。从市场部分的角度来看,MLF®包装解决方案代表了5个独特市场的2022年> 111b单位市场:汽车,消费者,工业,计算/联网, 和通讯。这些市场的包装解决方案要求各不相同,但基本价值MLF®包装使每个包装始终相同:(1)柔性外形;(2)适应性的互连技术;(3)电和热表现;(4)具有成本效益的解决方案。

MLF的柔性外形®包装启用技术为所有市场提供服务,满足独特的维度,环境和应用要求。例如,已证明形成腔的能力可以使MLF®在mems和传感器市场以及改变包装厚度的能力使这项技术能够满足便携式手持市场的苛刻规模要求。
已经证明了多个互连解决方案,从传统的电线键设计到高颠簸计数不等铜支柱翻转芯片设计。各种直径的AU,CU和AG线的使用解决了性能和成本的要求,同时使宽阔互连解决方案需要各种晶圆技术,例如硅,gan和SOS,其技术节点的范围从120 nm到7 nm不等。

裸露的模具固定垫(顶部,底部或两者都)功能使该包装技术具有独特的功能,以满足高性能网络设备和电源设备的热需求。整合大直径粘结线和CU夹的能力力量FET启用了MLF®包装解决方案可以扩展到高功率应用程序,并满足从汽车到消费游戏产品的苛刻市场需求。
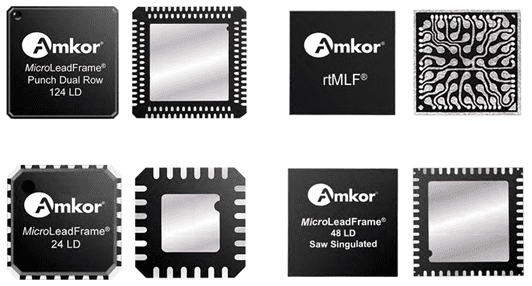
新材料集专门针对零分层以及QEC-Q-100和AEC-Q-006的苛刻汽车可靠性要求将该技术的用例扩展到先前由铅软件包解决方案所主导的应用程序,例如LQFP,,,,MQFP,,,,TQFP, 和Soic。粗糙的LeadFrame饰面,改进的环氧脱落材料,用于汽车应用的膜模具附着以及改进的成型化合物以增强CU线的性能扩展了MLF的值®包装技术。
Amkor的MLF®技术是一种适应性,创新和成本敏感技术的市场。利用柔性外形和适应性的互连功能在组合中独特地定位MLF®满足各种市场需求和应用需求。让Amkor与您合作,以确定满足您需求的最佳解决方案。



