改善翘曲控制和完整性的封装
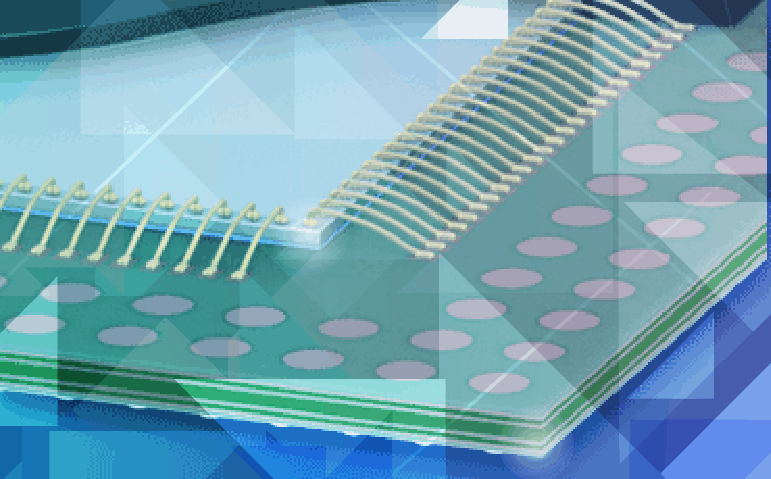
便携式产品,如手机,数字相机,游戏和其他移动应用能够从层叠封装(流行)系列的堆叠及小面积封装组合中获益。
公司承诺保持一流的开发和制造能力,以确保我们能够走在满足新一代流行需求的前沿,例如,更高密度的堆叠接口,流行贴装区域,以及高度缩减等。
底部可堆叠极小节距BGA (PSvfBGA)于2004年推出,采用焊线或混合(倒装芯片和焊线)堆叠支持单晶粒和堆叠晶粒,通过测试和SMT处理,它被运用于改善倒装芯片翘曲控制和封装完整性。
底部可堆叠倒装芯片CSP (PSfcCSP)在PSfcCSP封装的fcCSP封装流水线上采用集成PSvfBGA封装堆叠设施特点的外露式晶片底部封装。PSfcCSP的薄型外露式倒装芯片晶片实现0.5毫米节距的小间距堆叠接口,它是中心模塑PSvfBGA结构的挑战之一。
穿塑通孔层叠封装(烟草花叶病毒®流行)是我们的新一代流行解决方案,它的互连通孔穿透模塑盖。烟草花叶病毒提供稳定的底部封装,让使用更大晶粒/封装比的更轻薄基板成为可能。烟草花叶病毒的流行可以支持单晶粒,堆叠晶粒或倒装芯片设计。此项技术是满足0.4毫米节距低功耗DDR2储存器接口要求的理想解决方案,能使堆叠接口兼容密度为0.3毫米及更小的焊球节距。
有问题?
点击下方的“获取信息”按钮,
联系公司专业人士。
